

Appendix _ Nexus ALD _ Mini Thermal ALD
System overview

Detail Specification
| No | Item | Description |
|---|---|---|
| 1 | Chamber Type | Lateral type (Traveling wave) |
| 2 | Reaction Type | Using Plasma & Thermal (H2O, DI) |
| 3 | Substrate Size | 8inch (200mm) |
| 4 | Dimension (WxLxH) | 700 x 1100 x 1260 mm |
| 5 | Weight | <120kg |
| 6 | Uniformity | ≤±2% (Within 25point EE15mm) ≤±1% (Wafer to Wafer) |
| 7 | Cycle Time | ≤ 10sec/Cycle |
| 8 | Growth Per Cycle | ≤ 1.2Å/Cycle |
| 9 | Deposition Rate | ≥ 7Å/min (Ref, Al2O3) |
| 10 | Plasma Power Source | RF 13.56MHz, CCP Type, 600W |
| 11 | RI | Al2O3 : 1.55~1.65 / SiO2 : 1.4 ~ 1.5 TiO2 : 1.9~2.0 and ETC |
| 12 | Transmittance | ≥ 95% (50nm Thickness On Glass) |
| 13 | WVTR (@50nm) | Single Layer : Low 10E-3 g/m2-day Nanolaminate : Low 10E-5 g/m2-day |
| 14 | Base Pressure | ≤ 5.0x10-3Torr (≤ 5min) |
| 15 | Process Pressure | 0.5~2 Torr |
| 16 | Substrate Temperature | Max. 400℃, ≤±1% (On Set Temp.) |
| 17 | Materials | Chamber: Al6061 Heater : Block heater |
| 18 | Available Deposition Film | Metal Oxide by O2 Plasma / DI / O3 Metal Nitride by NH3 , N2 Plasma Metal by H2 Plasma |
| 19 | O3 Generator (Option) | O3 Generator _ 220g/cm3 _ 2L/min |
| 20 | Vacuum Gauge | ATM Switch |
| Baratron Gauge(<10 Torr) | ||
| 21 | Pump Type | Oil Rotary Pump (<1000L/min) |
| 22 | ETC | By-pass Line at each Feeding Line Laptop Notebook Control |
Plasma Mini ALD System PNID
PNID

GDS Configuration
1. Source Feeding Canister
: 3 Source (3 Bubbler Type)
: 250cc
: 3 Source (3 Bubbler Type)
: 250cc
2. Reactant Feeding Canister
: 1 Reactant (D.I., 1 Self Evap. Type)
: 130cc
: 1 Reactant (D.I., 1 Self Evap. Type)
: 130cc
3. External Reactant Gas Feeding
: 2 Gas Reactant (O2, TBD)
: 2 Gas Reactant (O2, TBD)
4. Gas Line & Canister Heating
: Canister (<150℃, Heating Jacket)
: Gas Line (<150℃, Band Heater)
: Canister (<150℃, Heating Jacket)
: Gas Line (<150℃, Band Heater)
5. MFC
: Ar (or N2) Gas : Max. 500sccm
: External Gas MFC (TBD)
: Ar (or N2) Gas : Max. 500sccm
: External Gas MFC (TBD)
6. Each Feeding gas has By-pass Line
PNID

GDS Configuration
1. Source Feeding Canister
: : 4 Source (4 Bubbler Type or TBD)
: 250cc
: : 4 Source (4 Bubbler Type or TBD)
: 250cc
2. External Reactant Gas Feeding
: 2 Gas Reactant (O2, TBD)
: 2 Gas Reactant (O2, TBD)
3. Gas Line & Canister Heating
: Canister (<150℃, Heating Jacket)
: Gas Line (<150℃, Band Heater)
: Canister (<150℃, Heating Jacket)
: Gas Line (<150℃, Band Heater)
4. MFC
: Ar (or N2) Gas : Max. 500sccm
: External Gas MFC (TBD)
: Ar (or N2) Gas : Max. 500sccm
: External Gas MFC (TBD)
5. Each Feeding gas has By-pass Line
Nexus Thermal Mini ALD System
System overview
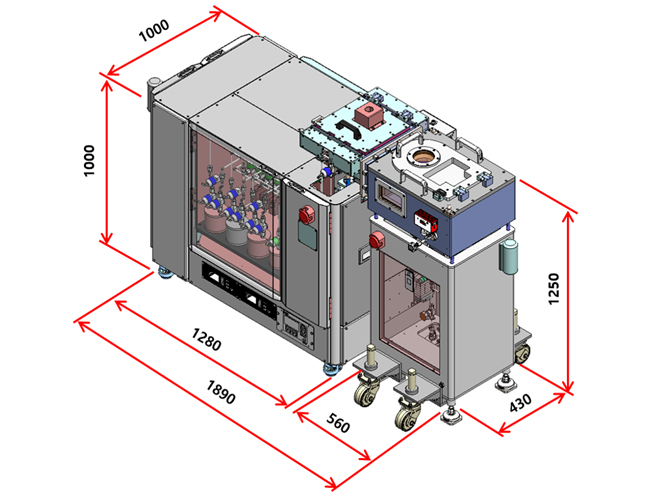
Detail Specification
| No | Item | Description |
|---|---|---|
| 1 | Chamber Type | Lateral type (Traveling wave) |
| 2 | Reaction Type | Plasma (O2, N2, H2) Thernal (D.I, O3) |
| 3 | Substrate Size | 150x150mm2 (6”) |
| 4 | Dimension (WxLxH) | 430x1890x1250mm |
| 5 | Weight | <120kg |
| 6 | Uniformity | ≤±2% (Within 25point EE15mm) |
| ≤±2% (Wafer to Warer) | ||
| 7 | Cycle Time | ≤ 10sec/Cycle |
| 8 | Growth Per Cycle | ≤ 1.2Å/Cycle |
| 9 | Deposition Rate | ≥ 15Å/min (Ref, Al2O3) |
| 10 | Plasma Power Sorce | RF 13.56MHz, HCP Type, 600W |
| 11 | RI | Al2O3 : 1.55~1.65 / SiO2 : 1.4 ~ 1.5 |
| TiO2 : 1.9~2.0 and ETC | ||
| 12 | Transmittance | ≥ 95% (50nm Thickness On Glass) |
| 13 | Base Pressure | ≤ 5.0x10-3Torr (≤ 5min) |
| 14 | Process Pressure | 0.5~2 Torr |
| 15 | Substrate Temperature | Max. 400℃, ≤±1% (On Substrate Temp.) |
| 16 | Materials | Chamber: Al6061 |
| Heater : Al Block heater | ||
| 17 | Available Deposition Film |
Metal Oxide by O2 Plasma / O3 |
| Metal Nitride by NH3 , N2 Plasma | ||
| Metal by H2 Plasma | ||
| MLD by EG | ||
| 18 | Vacuum Gauge | ATM Switch |
| Baratron Gauge(<10 Torr) | ||
| 19 | Pump Type | > 1000L/min |